
本文对比研究了商品化银浆体系和新银浆体系的润湿性对芯片键合性能的影响。
银浆:新型银浆体系(记为 B),其与银浆A体系的区别在于粘合促进剂的不同。
基底:环氧玻纤基材。
采用德国 KRÜSS 公司的 DSA100 测量银浆与基材的接触角。

DSA100接触角测试仪
银浆B在基材上的接触角低于银浆A,表明银浆B的浸润性良好,有利于在基板和芯片中间产生连续的银浆层。
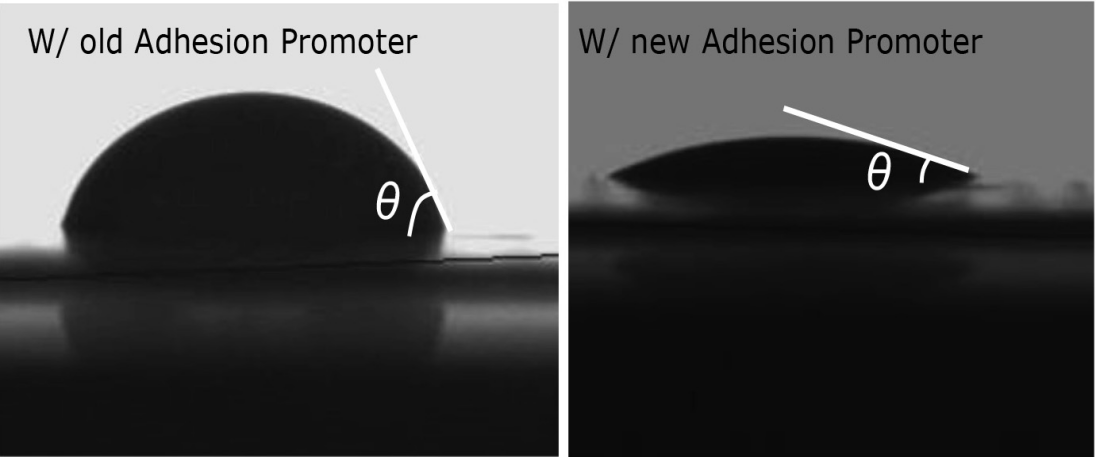
而剖面形貌分析也证实银浆 B在芯片表面形成了连续的银浆键合层。对银浆A的芯片键合层剖面进行观察,发现银浆A的键合层存在空洞,证明银浆在点胶过程中没有完全浸润基材的表面,使空气封闭在键合层中。而空气在银浆固化的过程中受热膨胀,不仅减小了界面处的银浆结合面积,减弱了键合强度,而且也导致了过高的键合层厚度。

图2,银浆 B 键合层剖面的 SEM 照片
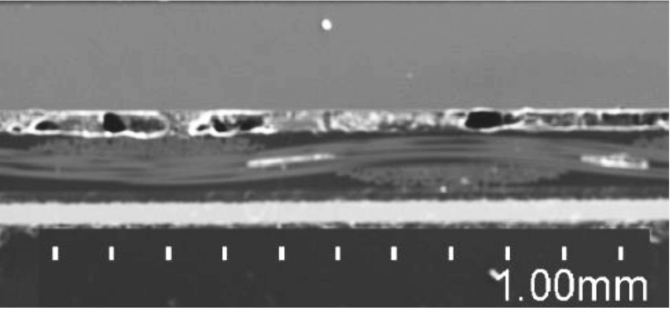
图3,银浆 A 键合层剖面的 SEM 照片
可看出减少银浆层的空洞是提高芯片键合强度的一种有效方法。合适的粘合促进剂可以帮助增加银浆在基材表面的浸润并减少界面银浆层里的空洞。
参考文献:
本文有删减,详细信息请参考原文。
堵美军,梁国正.高芯片键合质量与高生产率的新型银浆体系的研究[J].中国集成电路,2021,1-2(260-261): 63-69.
 2124
2124
 4
4- 1聚氨酯不含铜、锌等有害杂质
- 2苏州天启高速混合机手册
- 3纳米石墨烯电镜检测
- 4纳米石墨粉粒度检测(复达)25-0630
- 5电池材料表征实践指南
- 6聚合物加工测试分析指南
- 7散量秤彩页
- 8无斗定量包装秤—毛重秤彩页

- 为什么纳米CeO2的最新研究进展值得关注?
- 为什么AFM、NC等期刊频繁报道多孔水凝胶的最新研究进展?
- 蓝宝石的10大应用
- 《JMST》顶刊揭秘:激光3D打印高强铝合金的“强韧协同”奥秘——协同晶粒细化策略
- NC、AFM等期刊报道银纳米线最新研究进展!
- 为什么ZIF-67的最新研究进展值得关注?
- 经典介孔分子筛SBA-15又有新进展!
- 利用蜂鸟声共振技术对穿心莲内酯纳米混悬剂的开发、表征和分子动力学模拟
- 大明化学氧化铝粉在低温烧结制粉中的应用
- Development, Characterization, and Molecular Dynamics Simulation of Andrographolide Nanosuspensions Utilizing Hummer Acoustic Resonance Technology
- 苏州碳丰科技首席科学家程金生老师以本公司名义在国际上发表关于石墨烯纤维的论文《石墨烯纤维纳米复合材料的合成及氨基酸检测的分析应用》:
- 介可视·散装物料库存管理雷达全景扫描系统在料仓、堆场中的应用
- 磷酸化修饰鬼臼果多糖的制备及生物活性
- DSR论文解读:Advanced Science News 报道中科院长春应化所新型非铂催化材料研究成果
- High-throughput preparation, scale up and solidification of andrographolide nanosuspension using hummer acoustic resonance technology(纳米混悬剂制备的前瞻性技术 - 蜂鸟声共振)
- 扫描电镜优秀论文赏析|飞纳台式扫描电镜电极材料上的应用


